

박막 계측학으로 필름 품질 향상

Malvern Panalytical은 다층 구조 기반 마이크로 및 광전자 장치의 개발 및 생산 관리를 위한 계측 솔루션을 제공합니다.

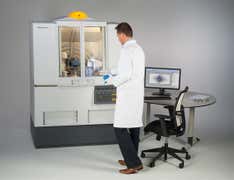

X선 방식에 기반한 XRD, XRR 및 XRF 등의 박막 계측학 도구는 빠르고 비파괴적입니다. 이러한 도구는 나노미터 단위까지 박막층, 이종구조 및 초격자 시스템의 중요 물질 변수를 대상으로 ex-situ 조사를 수행하는 데 있어서 강력한 성능을 발휘하는 것으로 입증되었습니다.
여기서 산출되는 정보는 필름 품질 최적화, 생산 효율성 향상 및 비용 절감에 필수적입니다.