2830 ZT
X-ray Fluorescence (XRF)
Solución avanzada de metrología de película delgada de semiconductores

Mejora de la calidad de la película mediante metrología de película delgada

Malvern Panalytical ofrece soluciones de metrología para el desarrollo y el control de producción de dispositivos optoelectrónicos y microelectrónicos estructurados en capas.
X-ray Fluorescence (XRF)
Solución avanzada de metrología de película delgada de semiconductores

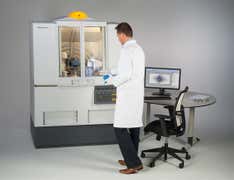
X-ray Diffraction (XRD)
Versátil sistema XRD de investigación, desarrollo y control de calidad

Las herramientas de metrología de película delgada basadas en métodos de rayos X, tales como XRD, XRR y XRF, son rápidas y no destructivas. Está comprobado que son potentes para la investigación ex situ de parámetros críticos de materiales de capas delgadas, heteroestructuras y sistemas de superredes hasta la escala de nanómetros.
La información derivada es esencial para optimizar la calidad de la película, lo que mejora la eficiencia de producción y reduce los costos.