2830 ZT
X-ray Fluorescence (XRF)
Solution avancée de métrologie des couches minces de semi-conducteurs

Amélioration de la qualité des couches par la métrologie des couches minces

Malvern Panalytical propose des solutions de métrologie pour le contrôle du développement et de la production de dispositifs micro et optoélectroniques à structure en couches.
X-ray Fluorescence (XRF)
Solution avancée de métrologie des couches minces de semi-conducteurs

X-ray Diffraction (XRD)
La nouvelle génération de diffractomètres polyvalents pour la recherche en matériaux
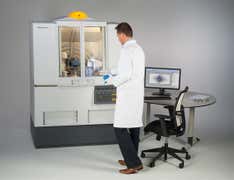
X-ray Diffraction (XRD)
La nouvelle génération de diffractomètres polyvalents pour la recherche en matériaux

Les outils de métrologie des couches minces basés sur des méthodes à rayons X, tels que XRD, XRR et XRF, sont rapides et non destructifs. Ils se sont révélés extrêmement efficaces pour l'étude ex situ des paramètres des matériaux critiques relatifs aux couches minces, aux hétérostructures et aux systèmes de super réseaux jusqu'à l'échelle nanométrique.
Les informations qui en résultent sont essentielles pour optimiser la qualité des couches, améliorer l'efficacité de la production et réduire les coûts.