
Empyrean
Mehrzweck-Röntgendiffraktometer
Dünnschichten, Oberflächen und Grenzflächen

Die Röntgenreflektometrie (XRR) ist ein Analyseverfahren zur Untersuchung von Dünnschichtstrukturen, Oberflächen und Grenzflächen unter Verwendung der Wirkung der vollständigen externen Reflexion von Röntgenstrahlen.
Die Reflektometrie wird unter anderem zur Charakterisierung von Einzel- und Mehrschicht-Strukturen sowie Beschichtungen in magnetischen, halbleitenden und optischen Materialien eingesetzt.
Bei Reflektivitätsexperimenten wird die Röntgenreflexion einer Probe um den kritischen Winkel herum gemessen.
Das tritt bei streifenden Einfallswinkeln auf. Unterhalb des kritischen Winkels der gesamten externen Reflexion durchdringen die Röntgenstrahlen nur wenige Nanometer in der Probe. Oberhalb dieses Winkels steigt die Eindringtiefe schnell. Bei jeder Grenzfläche, an der sich die Elektronendichte ändert, wird ein Teil des Röntgenstrahls reflektiert.
Die Interferenz dieser teilweise reflektierten Röntgenstrahlen erzeugt das Oszillationsmuster, das bei Reflexionsexperimenten beobachtet wird. Von diesen Reflexionskurven können Schichtparameter wie Dicke und Dichte, Grenzflächen- und Oberflächenrauheit bestimmt werden, unabhängig von der Kristallinität der einzelnen Schichten (einkristallin, polykristallin oder amorph).
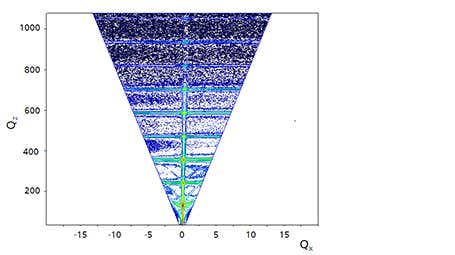

Mehrzweck-Röntgendiffraktometer
Reflektometrie-Experimente können auf den Empyrean-Systemen von Malvern Panalytical durchgeführt werden.
Die reflektometrischen Daten können mithilfe mehrerer automatischen Anpassungsverfahren im Reflectivity-Softwarepaket analysiert werden. Als Teil der XRD-Software von Malvern Panalytical verwendet Reflectivity das XRDML-Datenformat. Durch die automatische Anpassung der Simulation an die experimentellen Reflexionskurven ist Reflectivity, früher Spezialisten vorbehalten, auch für Anhänger geeignet.