

Improving film quality by thin film metrology

Malvern Panalytical offers metrology solutions for the development and production control of layer-structured based micro- and optoelectronic devices.

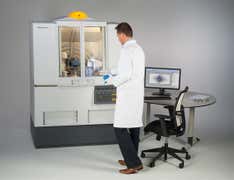

Thin film metrology tools based on X-ray methods, such as XRD, XRR and XRF, are fast and non-destructive. They have proven to be powerful for ex-situ investigation of critical materials parameters of thin layers, heterostructures and superlattice systems down to nanometer scale.
The resulting information is essential for optimizing film quality, enhancing production efficiency and reducing costs.