Stratos
薄膜の厚さと組成分析用
薄膜の厚さと組成分析用
薄膜と多層物質はいたるところに存在します。 たとえば、宝石、被覆鋼やその他の鉱物から集積回路まで、あらゆる用途に使用されています。 薄膜と多層物質の製造には、厚さと組成物を精密に管理することが不可欠です。
優れた再現性と非破壊検査を組み合わせるXRFは、薄膜の組成と厚さを分析するための非常に重要な技術です。 XRFによる厚さ測定の再現性は、±0.1 nmになります。
これまでは、薄膜分析のXRFキャリブレーションの手順には、特に多層構造において課題がありました。 一般的に、標準物質は分析するサンプルと同様の構造と組成を有している必要があります。 通常、これらの標準物質は高価で、購入可能であっても取得は困難です。
Stratosは、XRFのキャリブレーション手順の柔軟性を大幅に簡素化し向上させることで薄膜の測定手順でのXRFの価値をさらに高めています。 Stratosにより、未知物質とは異なる標準物質を使用でき、薄膜と多層物質を分析するために多量にある材料をキャリブレーションすることもできます。
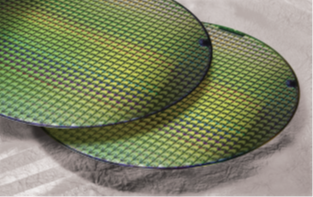
Stratosには、複雑な構造に対するXRFの応答をシミュレートできるVirtual Analystが搭載されています。これにより、層に関連する厚さと濃度レベルの変化を測定するのに最適な蛍光線を即座に実証することができます。
これにより、薄膜分析の測定方法の設定が大幅に簡素化されます。
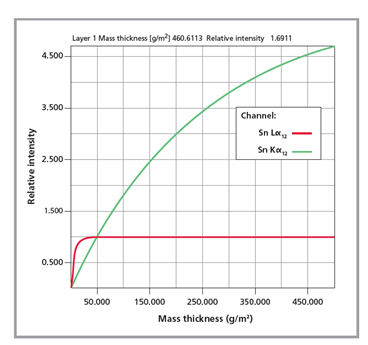
Stratosモジュールは、Zetium、Axios、またはMagiXおよびEpsilonモジュールベンチトップシリーズを含むMalvern Panalytical XRF装置のソフトウェアライセンスで構成されています。
Omnianとシームレスに組み合わせることができます。 Omnianがインストールされているシステムの場合、Omnianの設定はStratosを使用した薄膜の分析に直接使用されます。
Omnianがインストールされていないシステムの場合、Omnianの設定サンプルがStratosの設定に使用されます。
このモジュールは、新しいシステムに付属していますが、SuperQまたはEpsilonソフトウェアを実行している既存の装置に後付けすることができます。