
X線回折装置(XRD)Empyreanシリーズ
多目的 X 線回折装置
薄膜, 表面と界面

XRR - X線反射率法(XRR)は、薄い層の構造、表面や界面を、X線の全外反射の効果を使用して調べるための分析技術です。 反射率法は、磁気材料、半導体材料、光学材料などの単層および多層構造やコーティングの特性を評価するために用いられます。
反射実験において、サンプルのX線反射は臨界角周辺で測定されます。 測定は斜入射角周辺で行われます。 全外反射の臨界角未満の場合、X線はサンプルに数ナノメートルほどしか侵入しません。 一方、臨界角を上回ると、侵入深さは急激に増大します。 電子密度が変わるあらゆる界面において、X線ビームの一部が反射されます。 反射実験においては、こうして一部が反射されたX線ビームの干渉により、発振パターンができます。 得られる反射カーブから、厚さや密度などの層パラメータや界面や表面の粗さを、各層の結晶性(単結晶、多結晶、非結晶)によらず決定できます。
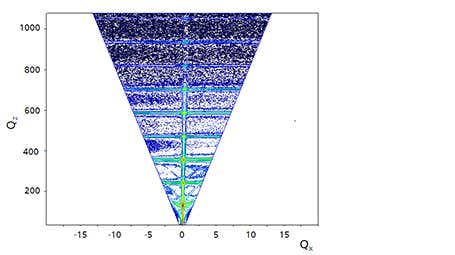

多目的 X 線回折装置
反射率法の実験は、Malvern PanalyticalのEmpyreanシステムで実施できます。
反射率法で得られたデータは、Reflectivityソフトウェアパッケージに実装されている各種自動フィッティングプロシージャを選択して分析できます。 Malvern PanalyticalのXRDソフトウェア製品のひとつ、Reflectivityでは、XRDMLデータ形式を使用します。 鏡面X線反射カーブのシミュレーションから実験への自動フィッティングを実現したことにより、Reflectivityはこれまで専門性の高いユーザーにしかできなかった反射率法を標準ユーザーでも実施できるようにしています。